在电子封装过程中,基板主要起机械支撑保护与电互连(绝缘)作用。随着电子封装技术逐渐向着小型化、高密度、多功能和高可靠性方向发展示,电子系统的功率密度随之增加,散热问题越来越严重。器件的散热影响条件众多,其中基板材料的选用也是关键的一环。
目前,电子封装常用的基板材料主要有四大类:聚合物基板;金属基板;复合基板;陶瓷基板。陶瓷基板材料以其强度高、绝缘性好、导热和耐热性能优良、热膨胀系数小、化学稳定性好等优点,广泛应用于电子封装基板。

陶瓷封装基板材料主要包括Al2O3、BeO和AlN等。目前,Al2O3陶瓷是应用最成熟的陶瓷封装材料,以其耐热冲击性和电绝缘性较好、制作和加工技术成熟而被广泛应用。
相对于塑料基和金属基,其优点是:(1)低介电常数,高频性能好;(2)绝缘性好、可靠性高;(3)强度高,热稳定性好;(4)热膨胀系数低,热导率高;(5)气密性好,化学性能稳定;(6)耐湿性好,不易产生微裂现象。陶瓷封装材料缺点是:成本较高,适用于高级微电子器件的封装,如航空航天和军事工程的高可靠、高频、耐高温、气密性强的封装;在移动通信、家用电器、汽车等领域也有着广泛应用。
美国、日本等国相继开发出多层陶瓷基片,使其成为一种广泛应用的高技术陶瓷,目前已投入使用的陶瓷基片材料有Al2O3、BeO和AlN、SiC和莫来石等。从结构与制作工艺,陶瓷基板可分为高温共烧多层陶瓷基板、低温共烧陶瓷基板、厚膜陶瓷基板、直接键合铜陶瓷基板等,下面将为大家分类说明。
一、高温共烧多层陶瓷基板
高温共烧多层陶瓷基板制备工艺是:先将陶瓷粉(Si3N4、Al2O3、AlN)加入有机黏结剂,混合均匀后成为膏状浆料,接着利用刮刀将浆料刮成片状,再通过干燥工艺使片状浆料形成生坯;然后依据各层的设计钻导通孔,采用丝网印刷金属浆料进行布线和填孔,最后将各生坯层叠加,置于高温炉(1600℃)中烧结而成。因为烧结温度高,导致金属导体材料的选择受限(主要为熔点较高但导电性较差的钨、钼、锰等金属),制作成本高,热导率一般在20~200W/(m·℃)(取决于陶瓷粉体组成与纯度)。
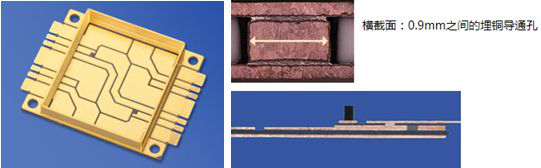
图1 多层氮化硅陶瓷覆铜基板(来源:京瓷)
二、低温共烧陶瓷基板
低温共烧陶瓷基板制备工艺与高温共烧多层陶瓷基板类似,其区别是在Al2O3粉体中混入质量分数30%-50%的低熔点玻璃料,使烧结温度降低至850~900℃,因此可以采用导电率较好的金、银作为电极和布线材料。但另一方面,因为低温共烧陶瓷基板陶瓷料中含有玻璃相,其综合热导率仅为2~3W/(m·℃)。此外,由于低温共烧陶瓷基板采用丝网印刷技术制作金属线路,有可能因张网问题造成对位误差;而且多层陶瓷叠压烧结时还存在收缩比例差异问题,影响成品率。
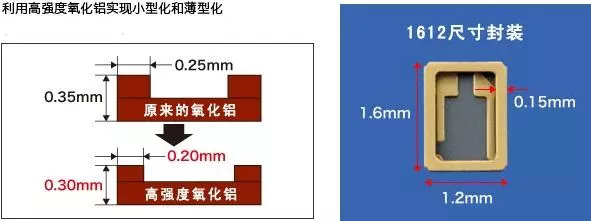
图2 Al2O3陶瓷电子封装材料(来源:京瓷)
这里需要注意的是,在实际生产中,为了提高低温共烧陶瓷基板导热性能,可在贴片区增加导热孔或导电孔,但缺点是会造成成本增加。同时为了拓展陶瓷基板的应用领域,一般采用多层叠压共烧工艺,可以制备出含腔体的多层结构(通常称为陶瓷管壳而非陶瓷基板),满足电子器件气密封装要求,广泛应用于航空航天等环境恶劣及光通信等可靠性要求较高的领域。
三、厚膜陶瓷基板
相对于高温共烧多层陶瓷基板和低温共烧陶瓷基板,厚膜陶瓷基板为后烧陶瓷基板。其制备工艺是:采用丝网印刷技术将金属浆料涂覆在陶瓷基片表面,经过干燥、高温烧结(700~800℃)后制备。金属浆料一般由金属粉末(Ag-Pd或Ag-Pt)、有机树脂和玻璃粉等组成。经高温烧结,树脂粘合剂被燃烧掉,剩下的几乎都是纯金属,由于玻璃质粘合作用在陶瓷基板表面。烧结后的金属层厚度为10~20μm,最小线宽为0.3mm。由于技术成熟,工艺简单,成本较低,厚膜陶瓷基板在对图形精度要求不高的电子封装中得到一定应用。
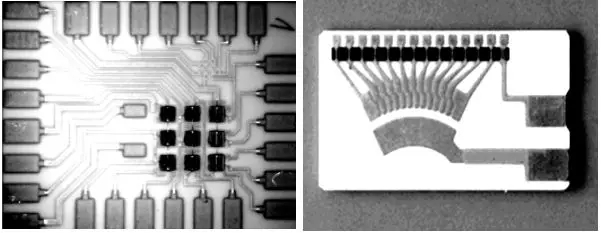
图3 厚膜陶瓷基板样品
四、直接键合铜陶瓷基板
直接键合铜陶瓷基板是由陶瓷基片(Al2O3或AlN)与铜箔在高温下(1065 ℃)共晶烧结而成,最后根据布线要求,以刻蚀方式形成线路。由于铜箔具有良好的导电、导热能力,而氧化铝能有效控制Cu-Al2O3-Cu复合体的膨胀,使直接键合铜陶瓷基板具有近似氧化铝的热膨胀系数。
直接键合铜陶瓷基板优点是:导热性好、绝缘性强、可靠性高等,已广泛应用于绝缘栅双极型晶体管(IGBT)、半导体激光器(LD)和CPV封装。特别是由于铜箔较厚(100~600μm),在IGBT和LD封装领域优势明显。
其缺点在于:1)直接键合铜陶瓷基板制备利用了高温下Cu与Al2O3间的共晶反应,对设备和工艺控制要求较高,基板成本较高。2)由于Al2O3与Cu层间容易产生微气孔,降低了产品抗热冲击性。3)由于铜箔在高温下容易翘曲变形,因此直接键合铜陶瓷基板表面铜箔厚度一般大于100μm;同时由于采用化学腐蚀工艺,直接键合铜陶瓷基板图形的最小线宽一般大于100μm。
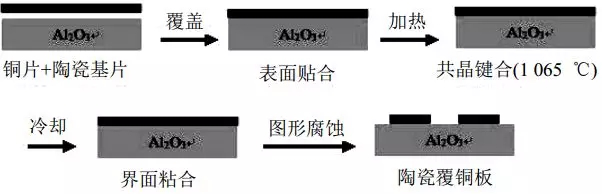
图4 直接键合铜陶瓷基板制备工艺流程
五、直接镀铜陶瓷基板
直接镀铜陶瓷基板制备工艺是:首先将陶瓷基片进行前处理清洗,利用真空溅射方式在基片表面沉积Ti/Cu层作为种子层,接着以光刻、显影、刻蚀工艺完成线路制作,最后再以电镀/化学镀方式增加线路厚度,待光刻胶去除后完成基板制作。
直接镀铜陶瓷基板优点:1)低温工艺(300℃以下),完全避免了高温对材料或线路结构的不利影响,也降低了制造工艺成本。2)采用薄膜与光刻显影技术,使基板上的金属线路更加精细(线宽尺寸20~30μm,表面平整度低于0.3μm,线路对准精度误差小于±1%),因此直接镀铜陶瓷基板非常适合对准精度要求较高的电子器件封装。特别是采用激光打孔与通孔填铜技术后(实现陶瓷基板上下表面互联),可实现电子器件三维封装,降低器件体积,提高封装集成度。
直接镀铜陶瓷基板缺点:1)电镀沉积铜层厚度有限,且电镀废液污染大。2)金属层与陶瓷间的结合强度较低,产品应用时可靠性较低。
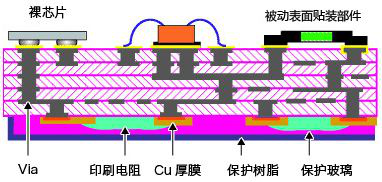
图5 氧化铝多层基板应用例
在实际生产时,对于陶瓷基板材料为了降低基板翘曲,一般采用三明治结构(陶瓷基片上下面同时制作金属层)。正面金属层用于贴装芯片,反面则用于平衡应力(由于金属与陶瓷热膨胀系数不匹配而产生),同时易于与下部的金属热沉焊接。
参考文献:
1、程浩,陈明祥,郝自亮,刘松坡,功率电子封装用陶瓷基板技术与应用进展,电子元件与材料。
2、崔嵩,黄岸兵,张浩,MCM用氮化铝共烧多层陶瓷基板的研究,电子元件与材料。
3、龙乐,低温共烧陶瓷基板及其封装应用,电子与封装。
想了解更多先进陶瓷产业链相关资讯,请扫码关注“CAC广州先进陶瓷展”公众号

【CAC2021广州国际先进陶瓷产业链展览会】期待您的莅临
2021年09月16日-18日,与您相约广州保利世贸博览馆6号馆!
版权声明:
本文为粉体圈原创作品,未经许可,不得转载,也不得歪曲、篡改或复制本文内容,否则本公司将依法追究法律责任。
